Prozesstechnologie
Wir bearbeiten Wafer von 2" bis 100 mm und unterschiedliche Substrate (GaAs, InP, Si, SiC, Saphir, GaN) mit hoher Reproduzierbarkeit. Mit einem modernen, nach industriellen Maßstäben ausgestatteten Prozessequipment entwickeln wir schnell Prozesse, überführen sie bei Bedarf in Kleinserien oder transferieren Prozessmodule an Partner. Die Prozesslinie umfasst die folgenden Technologien zur Strukturierung von Wafern bis hin zur Chipvereinzelung:
Lithografie
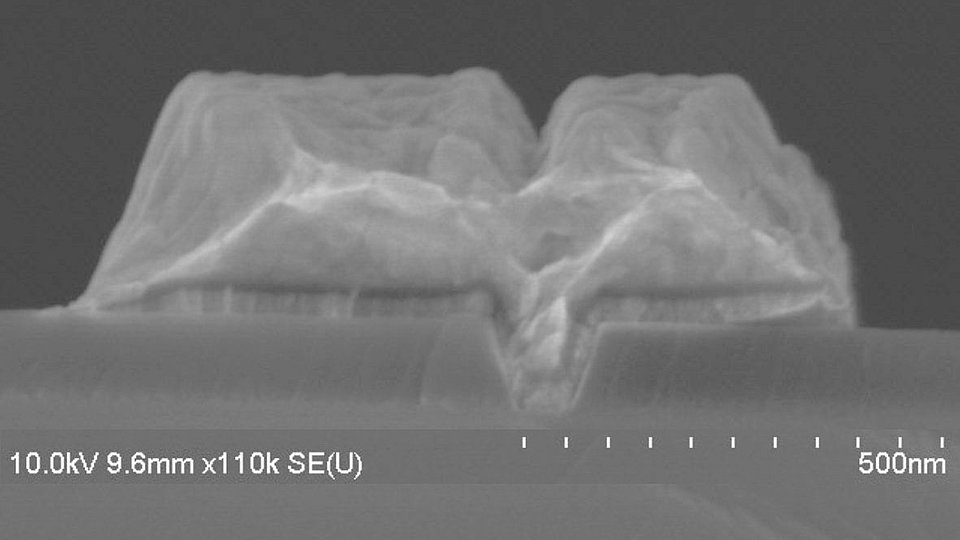
Fotolithografie
- bis 100 mm Waferdurchmesser einschließlich Sondergrößen und Teilstücke
- i-Line Belichtung (365 nm) mit Stepper und Maskaligner
- Strukturgrößen bis minimal 350 nm
Elektronenstrahllithografie
- 2" - 100 mm Waferbelichtung mit Form- und Punktstrahlanlagen
- 100 - 150 mm Maskenbelichtung
- 30 nm Formstrahl und 6 nm Punktstrahl
Ätzen
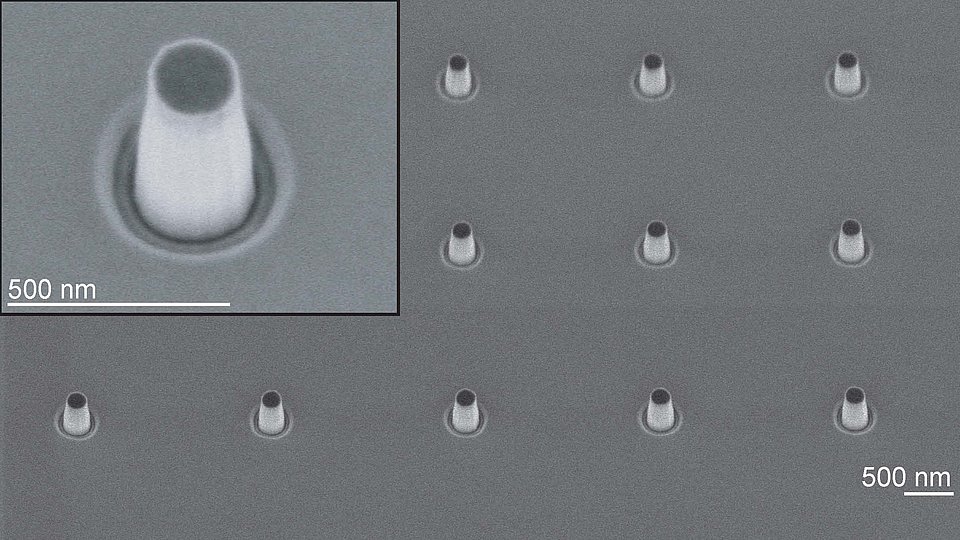
Nasschemisches Ätzen
- manuelle und automatisierte Ätzprozesse
- materialselektives Ätzen mit Ätzstopp
- kristallographisches Ätzen
- gezieltes Unterätzen
Trockenchemisches Ätzen
- RIE- und ICP-basierte Verfahren
- in-situ Prozesskontrolle mittels Laserinterferometrie
- etablierte Prozesse für Halbleiter, Dielektrika, Metalle und Polymere
Abscheideverfahren

- PECVD-Abscheidung von Isolatoren
- Thermische und plasmaunterstützte ALD (Atomic Layer Deposition)
- Elektronenstrahlbedampfung diverser Metalle
- HF- und DC-Sputterverfahren für Metalle und Dielektrika
- galvanische Goldabscheidung
Ionenimplantation
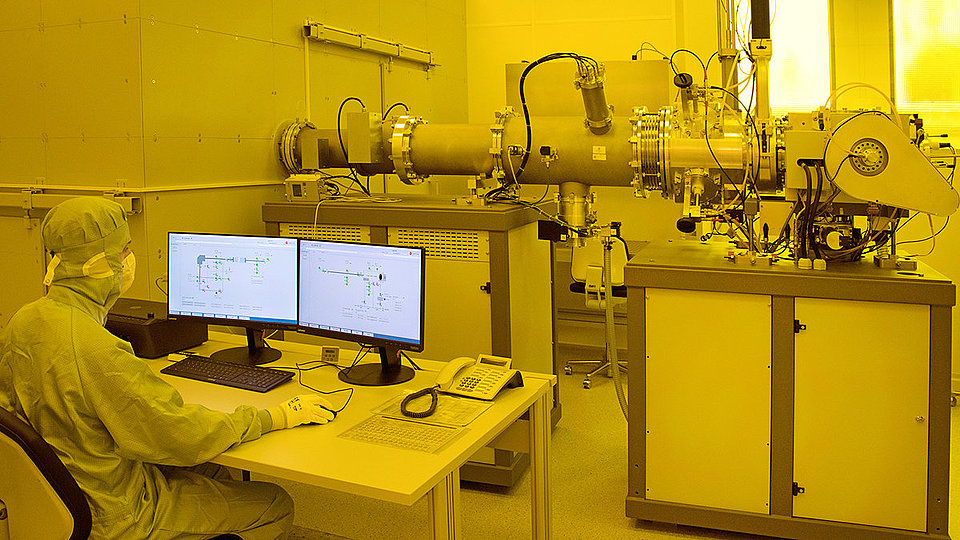
- Mittelstrom-Implantationanlage 15 keV bis 500 keV
- beheizbarer Chuck bis 800 °C
- Ionen aus gasförmigen, festen und flüssigen Ausgangsstoffen
- Einfach- und Mehrfach-Implantationen
- Simulation von Implantationsprofilen
Thermische Prozesse
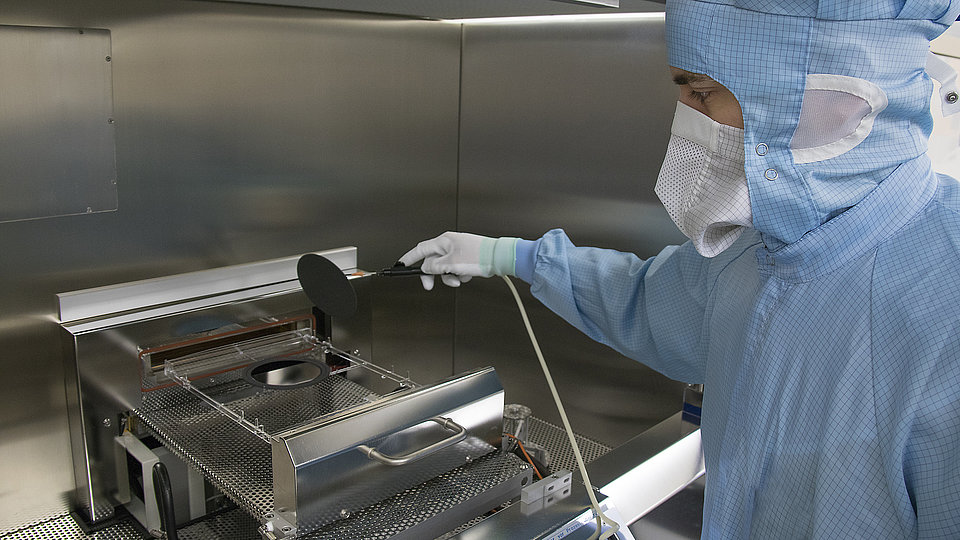
Rapid Thermal Annealing (RTA)
- unter N2-, N2/O2- oder Ar-Atmosphäre bis zu 1100 °C
- unter N2-, Ar- oder Formiergas-Atmosphäre bis zu 1600 °C
Entspannungstempern
- unter N2- oder Ar-Atmosphäre bis 800 °C
DC-Prozessmesstechnik

- Inline PCM- und TLM-Messungen auf verschiedenen Waferprobern
- Kapazitätsmessung im Bereich 1 kHz bis 5 MHz (1 mHz Auflösung)
- Nadelkarten mit bis zu 18 Pins
- Messbereich: 10 fA bis 1 A bzw. 10 nV bis 200 V
Abdünnen
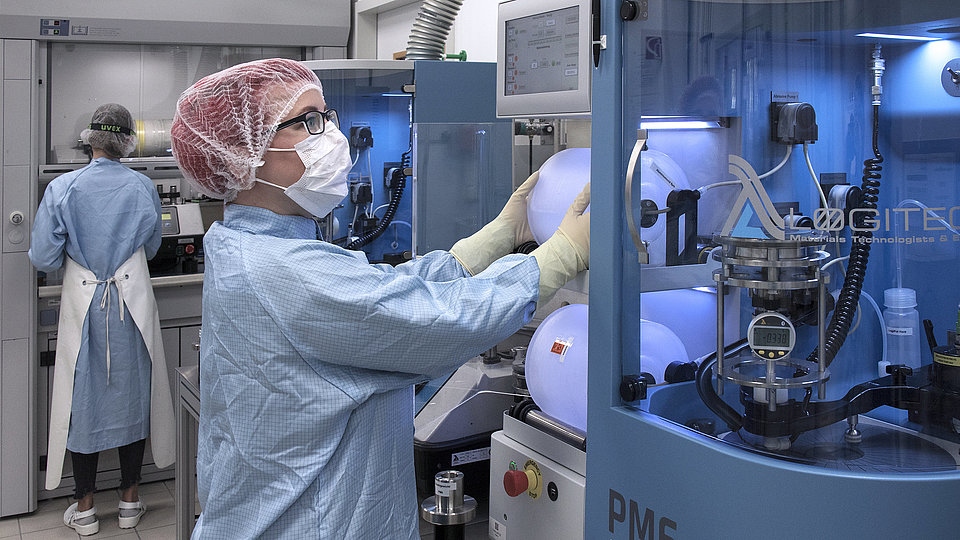
- Läppen und Polieren von GaAs, SiC, Saphir, GaN und Silizium
- Wafergrößen von 2", 3" und 100 mm Wafern sowie Teilstücken
- Dickenhomogenität bis zu +/- 2 µm über einem 100 mm Wafer
- Grinden von Si, Saphir, SiC, GaN
Sägen

- Sägen von z.B. GaAs, Saphir, SiC, Al2O3, Si, Quarzglas
- Bearbeitung von 2" bis 150 mm Wafern sowie von Waferteilstücken
- Chips auf Folie im Standard-Sägerahmen "ready for pick and place"
- Lasersägen: Ritzen und Durchsägen (fullcut) von Si, SiC, GaN, InP, AlN, Saphir bis zu 200 mm Substrate
- Laserritzen mit Fokustiefen innerhalb des Materials zur internen Modifikation z. B. zur Reduzierung des Biegeradius
Lasermikrostrukturierung
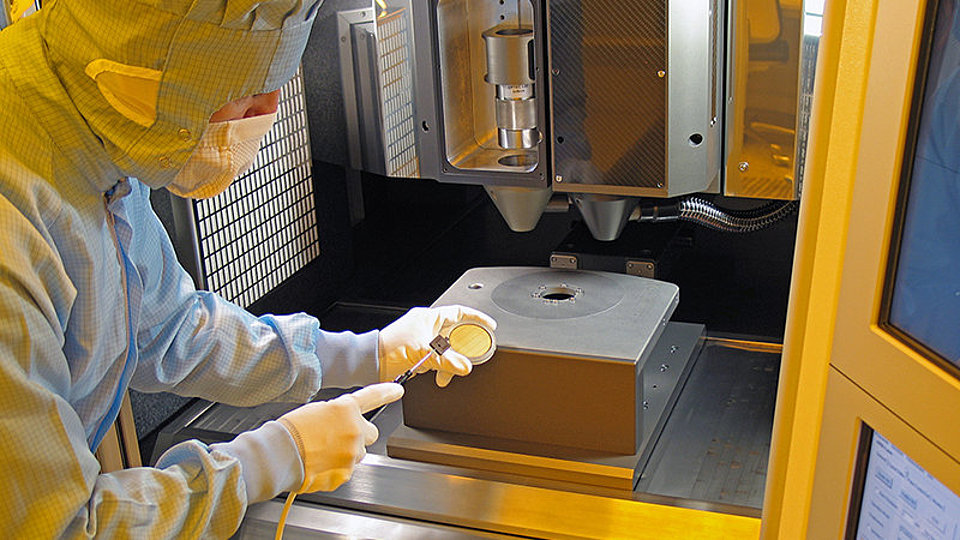
- Mikrobearbeitung mit Pulslasern
- Ritzen, Schneiden, Bohren von SiC, GaN, AlN, Si und Saphir
Prozessbegleitende Analytik
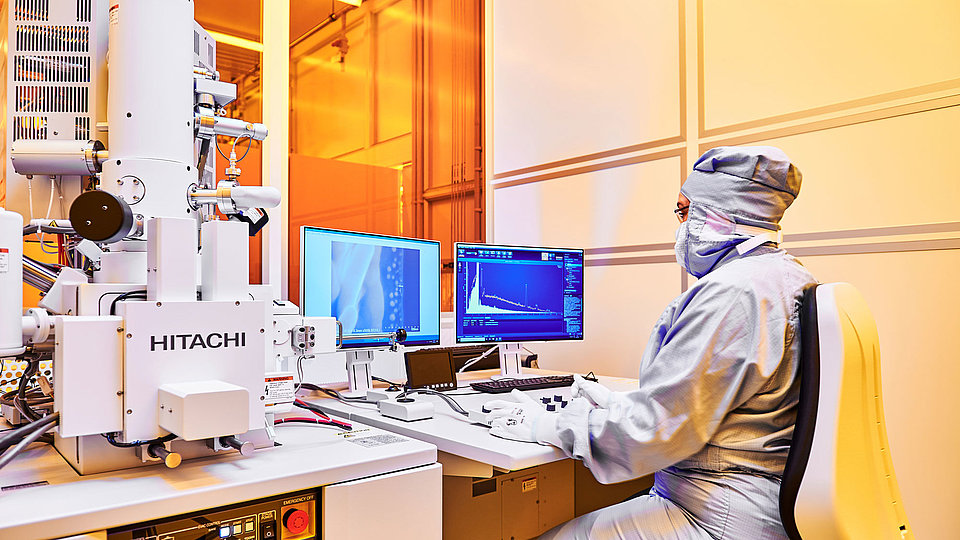
- Ellipsometrie
- Reflektometrie (200 - 980 nm)
- Röntgenfluoreszenzanalyse (XRF)
- Energiedisperse Röntgenspektroskopie (EDX)
- Rasterelektronenmikroskopie (REM)
- Weißlichtinterferometrie
- Profilometrie
- Defektdichtemessung
- Akustische Mikroskopie
- Rasterkraftmikroskopie (AFM, C-AFM)
Wir bieten kundenspezifische Waferprozesse und fertigen Masken sowie Reticles:
-
Technologieangebot - Übersicht
mit weiteren Informationen zu Angebot und Ausstattung (pdf)
